idonus 氫氟酸(HF)蒸汽相蝕刻(VPE)系統是一種潔凈室微加工設備。HF蒸汽通過熱控蝕刻二氧化硅層,實現無粘附釋放微機電系統(MEMS)。
idonus 提供多種氫氟酸(HF)蒸汽相蝕刻(VPE)產品。HF VPE(以下簡稱VPE)基于HF酸的化學反應,能夠選擇性蝕刻二氧化硅(SiO?),而硅(Si)保持完好。標準VPE適用于不同直徑的晶圓,包括100 mm、150 mm 和 200 mm。
1. 產品概述
idonus 氫氟酸蒸汽相蝕刻(VPE)設備用于潔凈室微加工設施,實現**無粘附(stiction-free)**的二氧化硅(SiO?)蝕刻。VPE 產品適用于 100 mm、150 mm 和 200 mm 的晶圓,并提供適用于更小晶圓或單個芯片的夾持解決方案。
VPE 設備可安全釋放微結構器件,尤其是具有微小間隙或易碎懸浮梁的器件(如梳狀驅動器、AFM 探針)。這些結構常見于微機電系統(MEMS)中。由于液態 HF 酸的內聚力可能破壞微小結構或導致其永久粘附,因此傳統液態 HF 酸無法用于此類工藝。而 VPE 采用 HF 酸蒸汽相蝕刻,使這些微結構可以無粘附釋放。
優點
- 安全處理HF酸
- 可重復使用的HF酸
- 簡便的晶圓夾持機制
- 適用于所有晶圓尺寸
- 無需額外安裝:設備可直接用于酸性濕法工藝平臺
- 晶圓反向蝕刻
- 背面保護
- 低運行成本
2. 蒸汽相 HF 的應用
HF 酸廣泛用于 MEMS 設備中選擇性蝕刻 SiO?。通常,在絕緣體上硅(SOI)晶圓中,SiO? 層既用作電氣絕緣層,也可作為犧牲層以釋放 MEMS 微結構。
在HF 酸蒸汽環境中蝕刻是一種準干法工藝,通過受控加熱基板,可以調節晶圓上的 HF 酸蒸汽量,從而以可重復的方式控制 SiO? 的蝕刻速率。
由于晶圓不與液體直接接觸,VPE 設備可以實現高產率的無粘附 MEMS 釋放。采用 HF 蒸汽相蝕刻 SiO? 的典型速率在 4 – 10 μm/小時 之間。
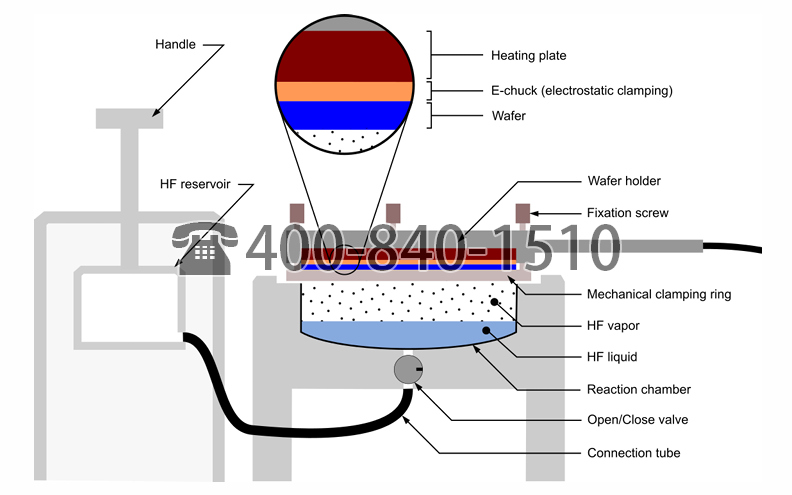
3. 產品描述
VPE系統由反應室和晶圓夾具組成。加熱元件集成在晶圓夾具中,用于控制待蝕刻基板的溫度。晶圓夾持有兩種方式:機械夾持或靜電夾持。在這兩種方式中,基板的隱藏面都能得到保護,避免被蝕刻。
- 晶圓可以通過夾緊環進行機械夾持。夾緊環通過晶圓夾具的背面進行螺栓固定,背面從不與HF蒸氣直接接觸。三個大聚合物螺絲便于佩戴防護手套時操作。
- idonus提供了可選的靜電夾持機制。可以夾持單個芯片(至少5毫米寬)或完整晶圓到加熱元件上。這種方案的優點是避免了機械夾持造成的應力集中。
一旦基板被夾持在晶圓夾具上,反應室可以充滿液態HF。然后,用晶圓夾具封閉反應室。HF在室溫下蒸發,蝕刻過程自動開始。蝕刻速率通過調整晶圓的溫度來控制,溫度可調范圍為35°C至60°C。
HF酸可以用于多次蝕刻。為此,HF儲液槽用于暫時儲存HF液體,供基板交換時使用:在處理完一個晶圓后,反應室中的酸液可以流入可密封的HF儲液槽。HF液體轉移通過降低HF儲液槽的手柄來簡單完成。通過連通容器,酸液流入HF儲液槽,并可以通過手動閥門關閉。重新填充反應室時,只需轉動閥門并提升手柄,酸液即可流回反應室。
VPE系統占地面積小,可以輕松集成到現有的流箱中。
4、可選配置
4.1. 多芯片靜電夾具
靜電夾具能夠通過靜電力將多個芯片或晶圓的部分夾持在晶圓夾具上。該設備在研發原型制作中非常有用,因為在某些情況下無法處理完整的晶圓。芯片的靜電夾持使得可以在HF蒸氣釋放之前對MEMS晶圓進行嚴苛的切割過程。通過修改傳統的制造流程,可以生產出具有極軟懸掛結構的MEMS設備。
使用靜電夾具非常簡單。將芯片放置在晶圓夾具上,然后通過控制單元上的開關打開靜電力。靜電力可以調節。
4.2. 晶圓夾具安全網和適配環
安全網是抗HF的網狀物,放置在反應室內(見圖6)。其目的是捕捉未附著在晶圓上的釋放部件。HF會在網狀物上凝結。因此,操作時必須戴上防護手套。150mm和200mm晶圓夾具的適配環可以用于適配更小的晶圓尺寸。
4.3. 反應室溫控
二氧化硅的蝕刻速率隨著反應室中液態HF的溫度變化而變化。HF的溫度取決于潔凈室的環境溫度。此外,長時間的蝕刻過程中HF會加熱(放熱反應),導致蝕刻速率從晶圓到晶圓逐漸增大,直到系統穩定為止。
5、應用
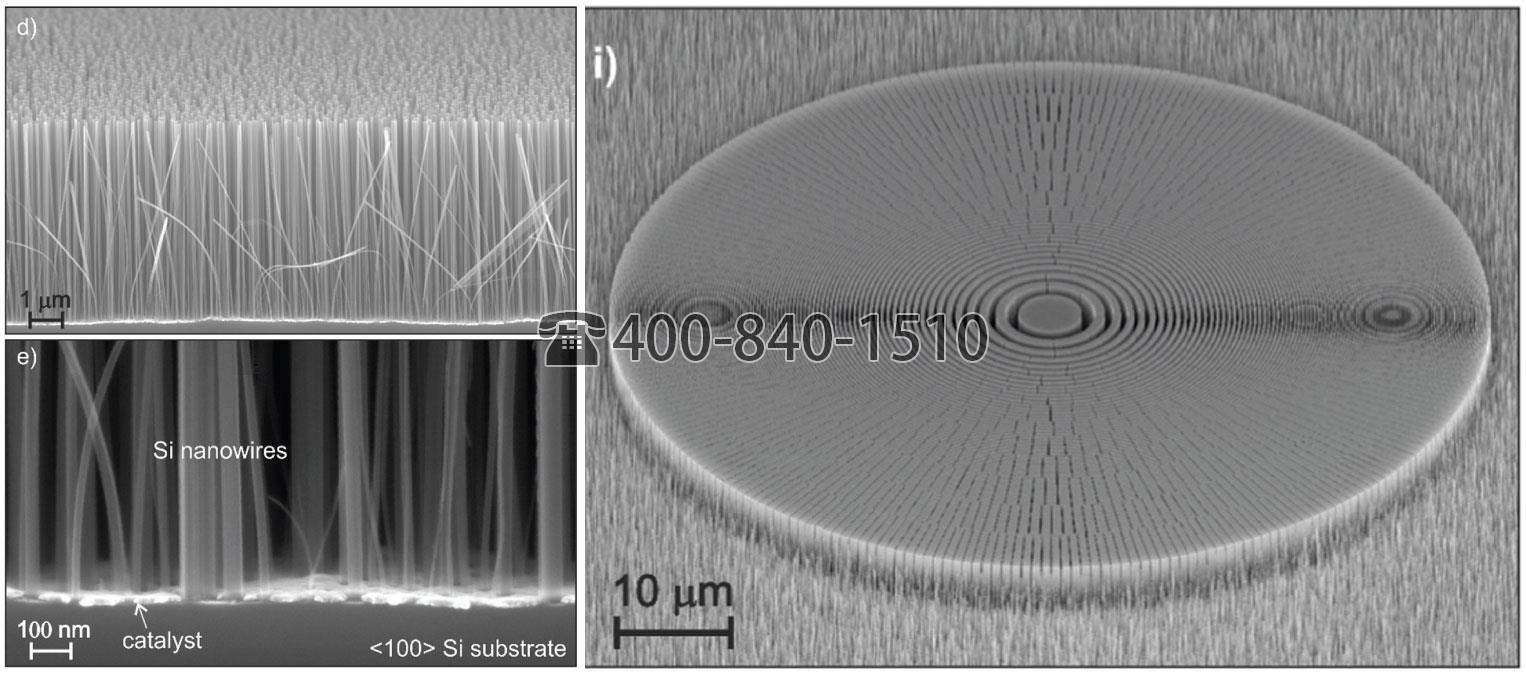
|
|
|
|
|
|
|
|
|